-
25 2022-02MEMS封装技术


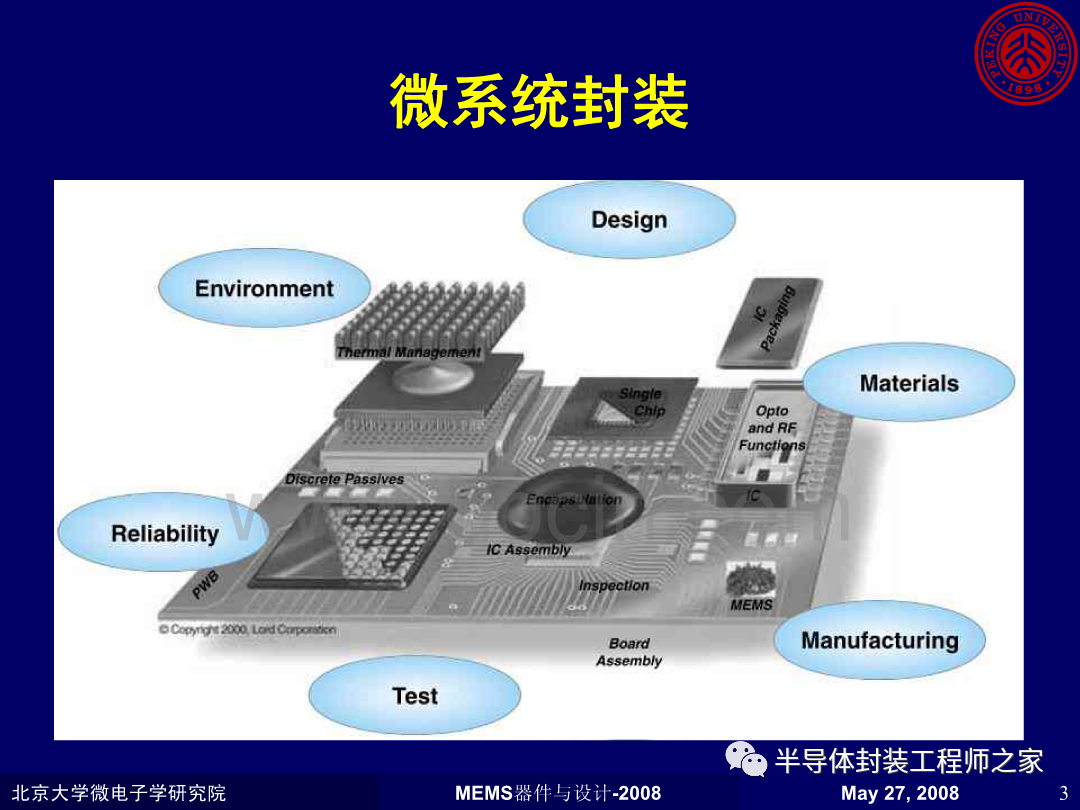











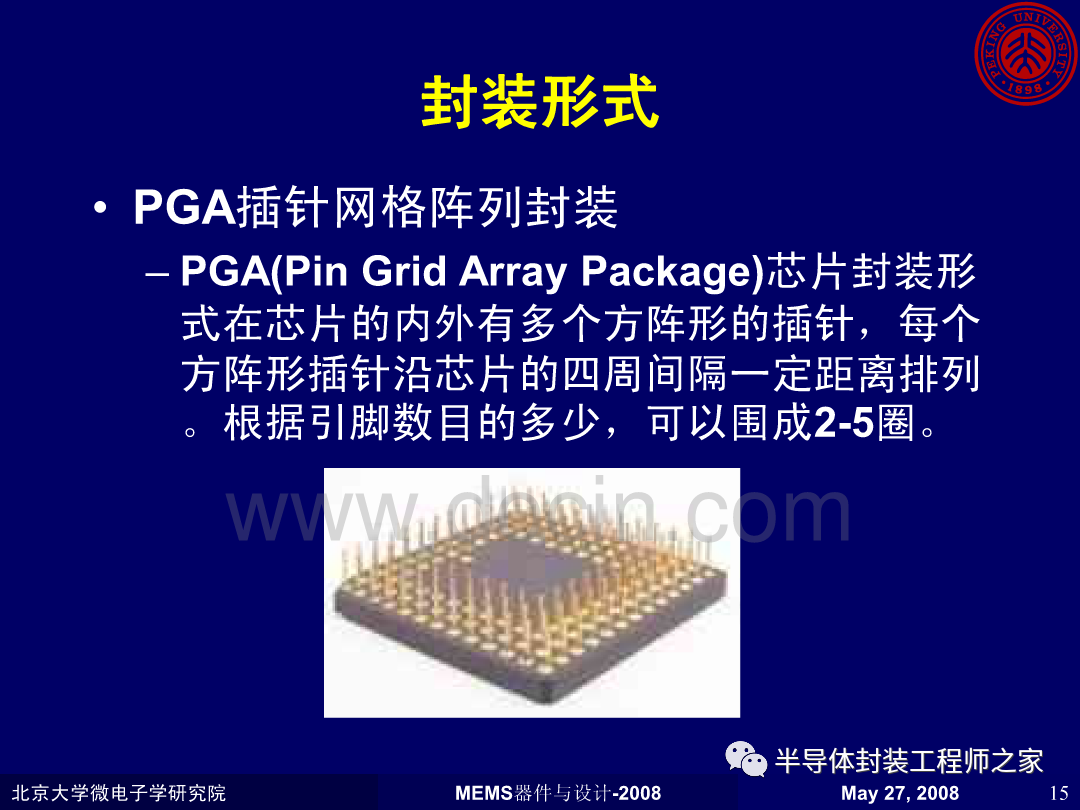

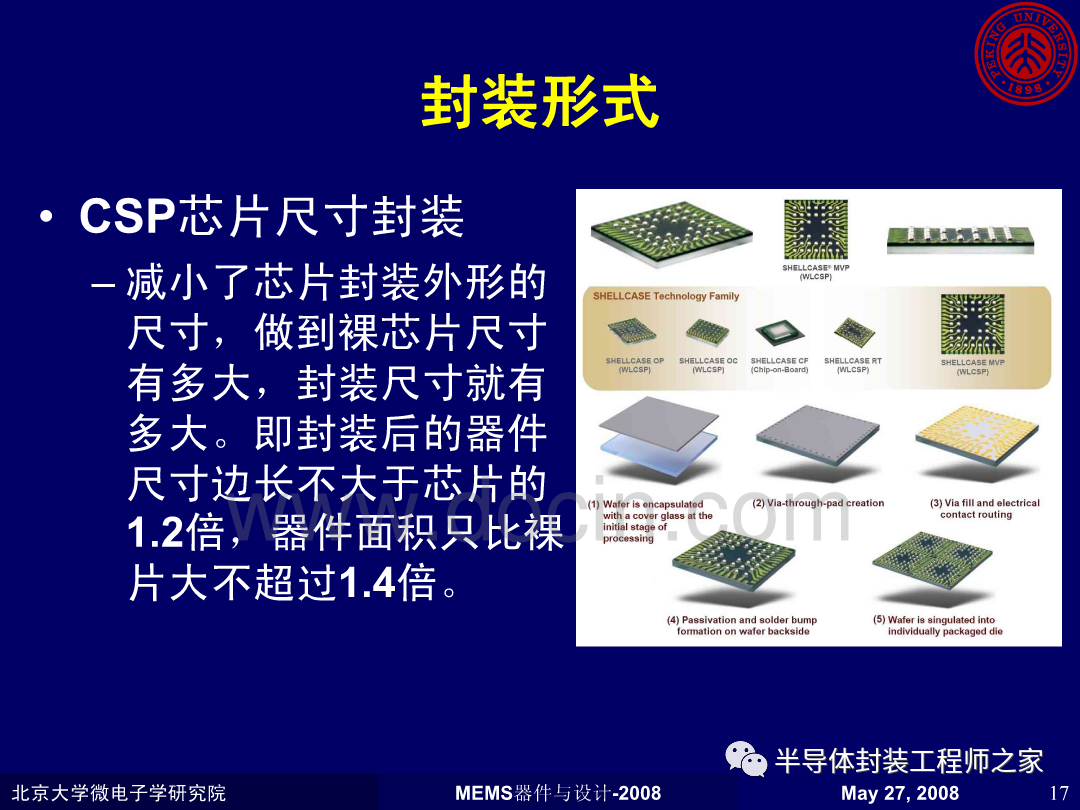

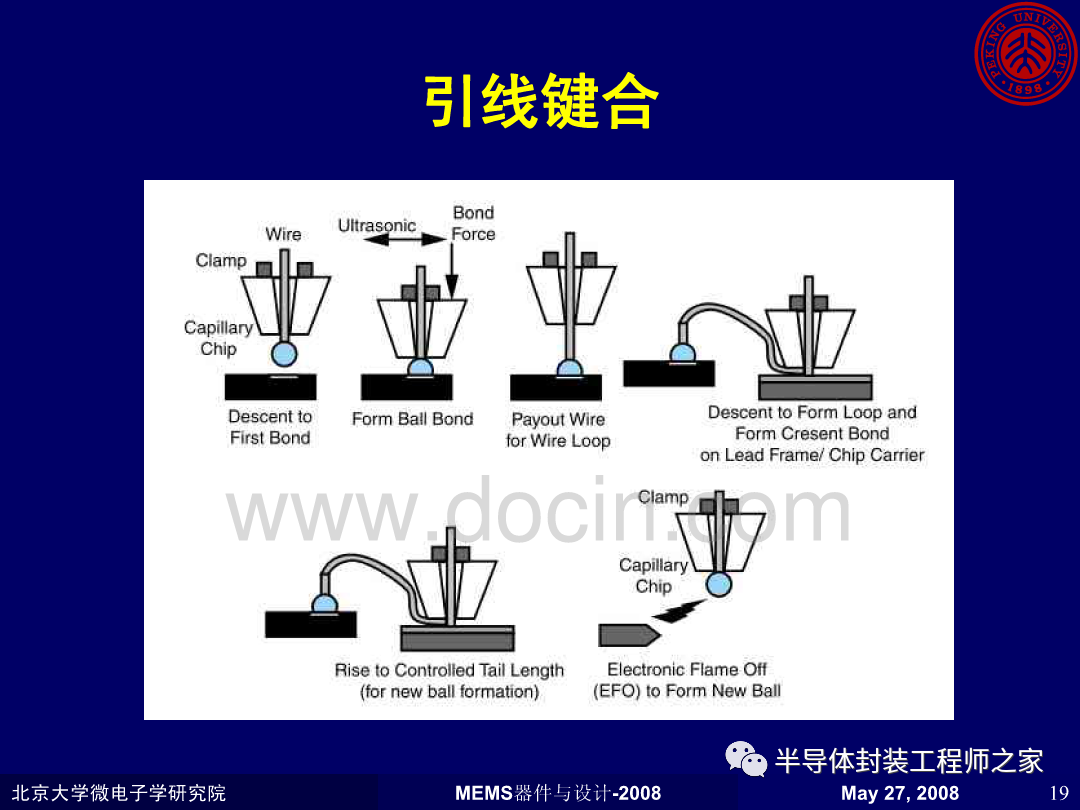
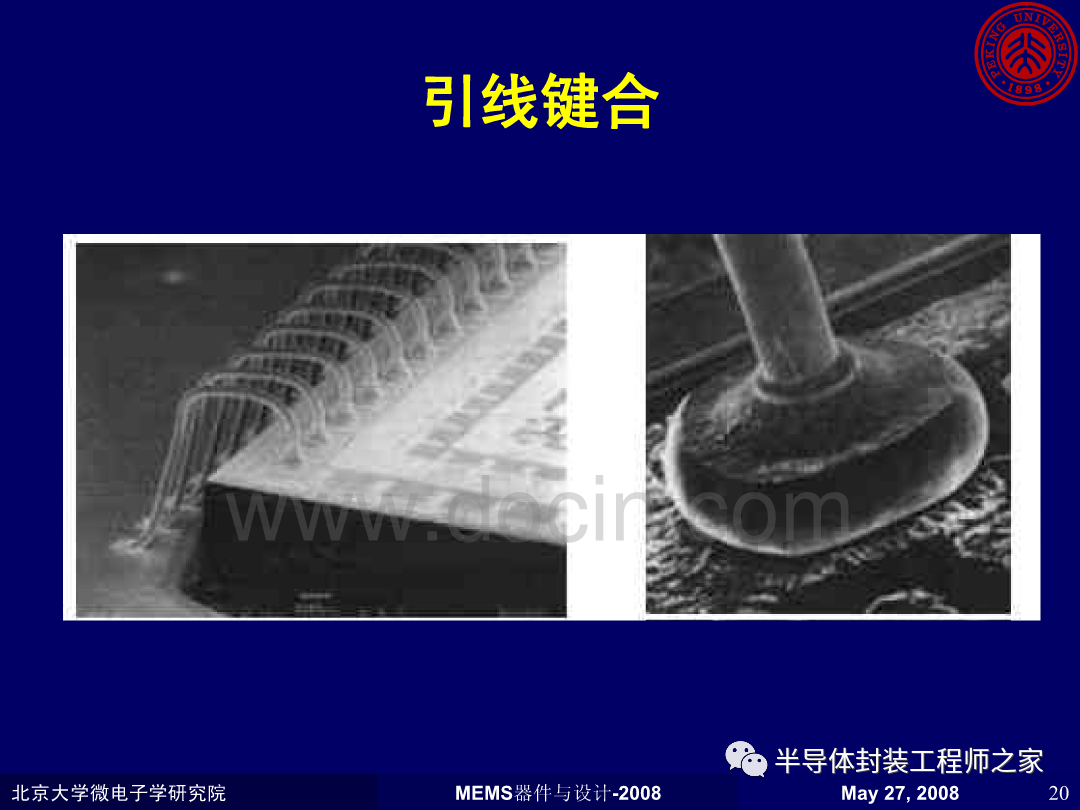

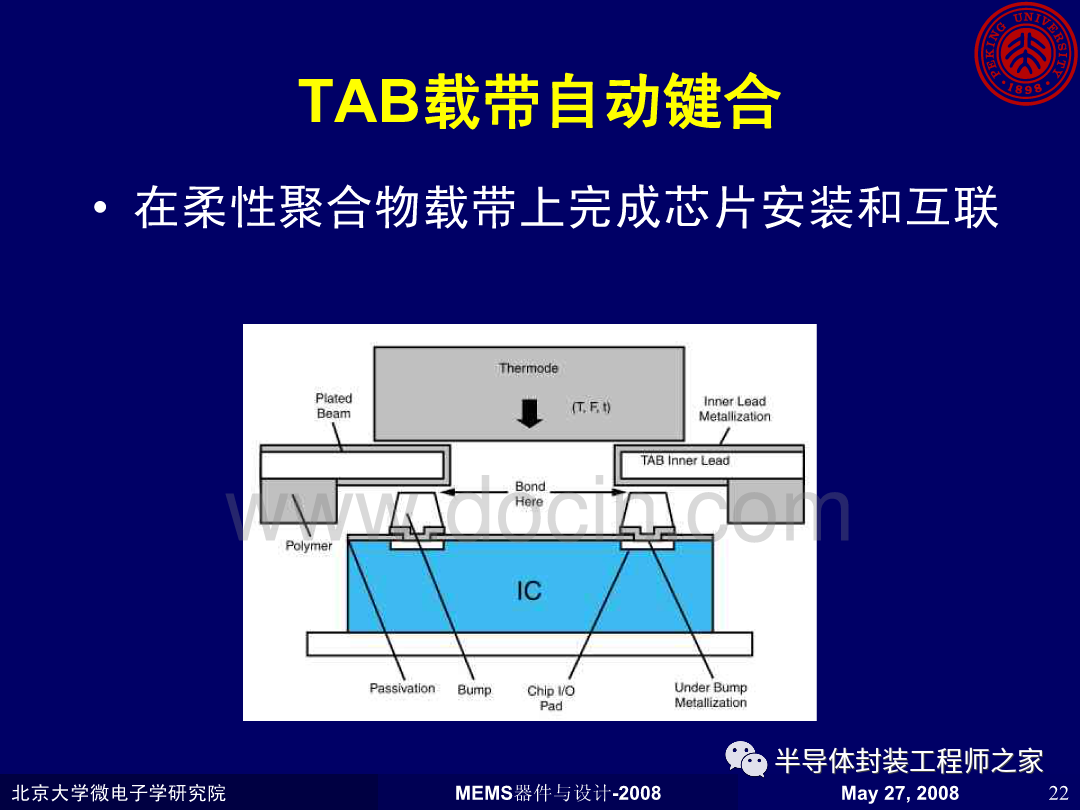


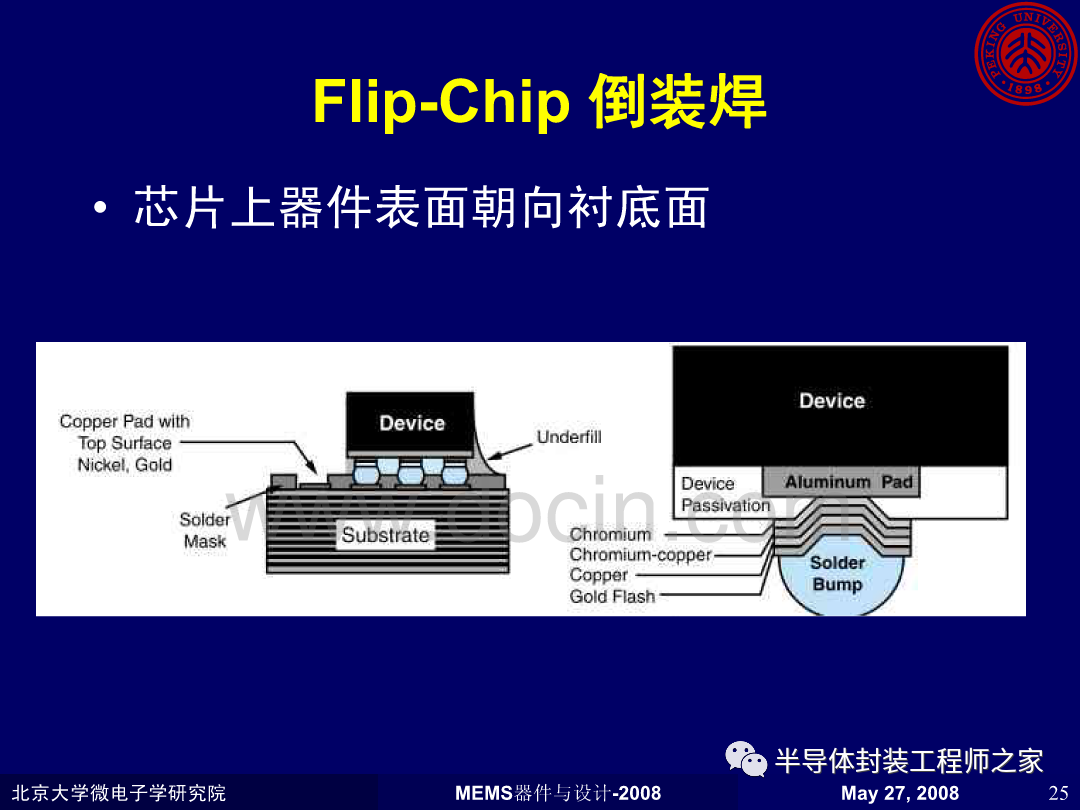
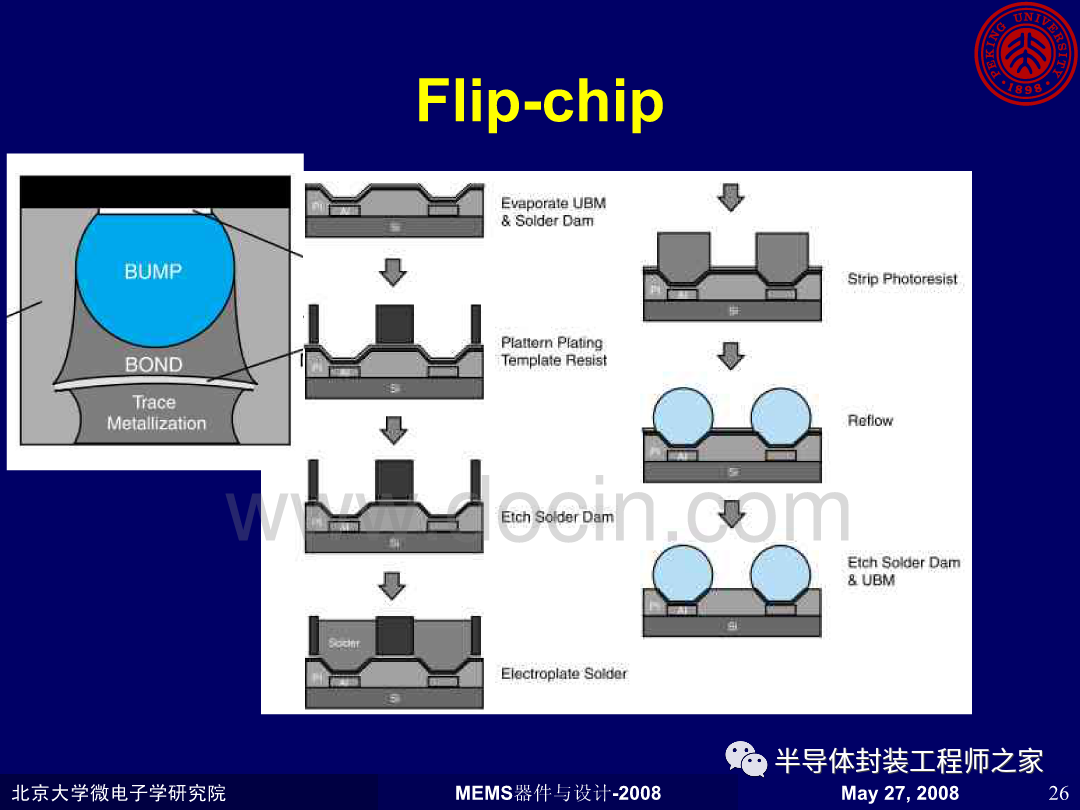







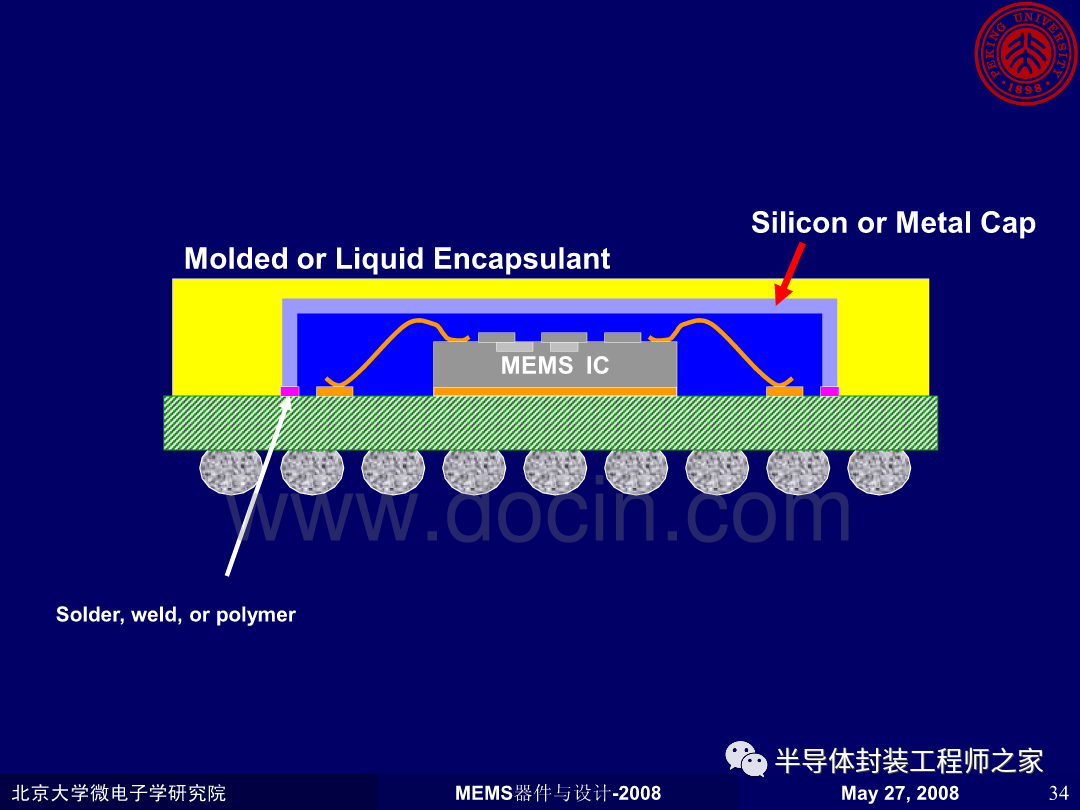
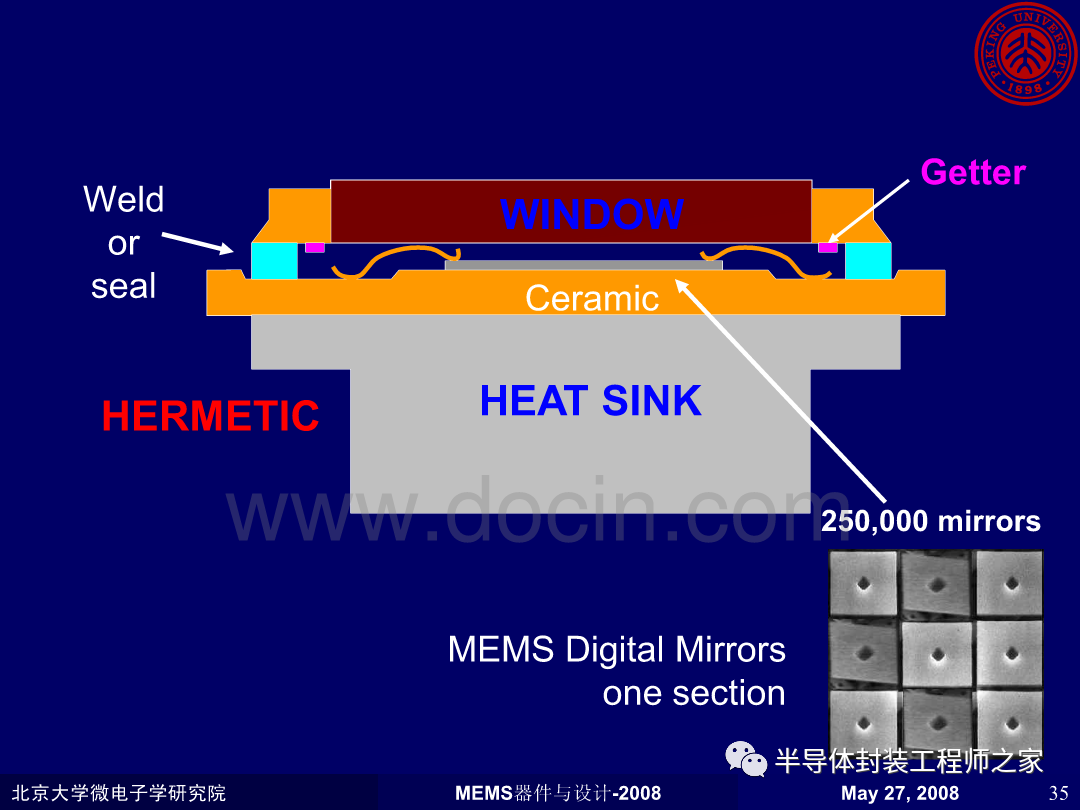








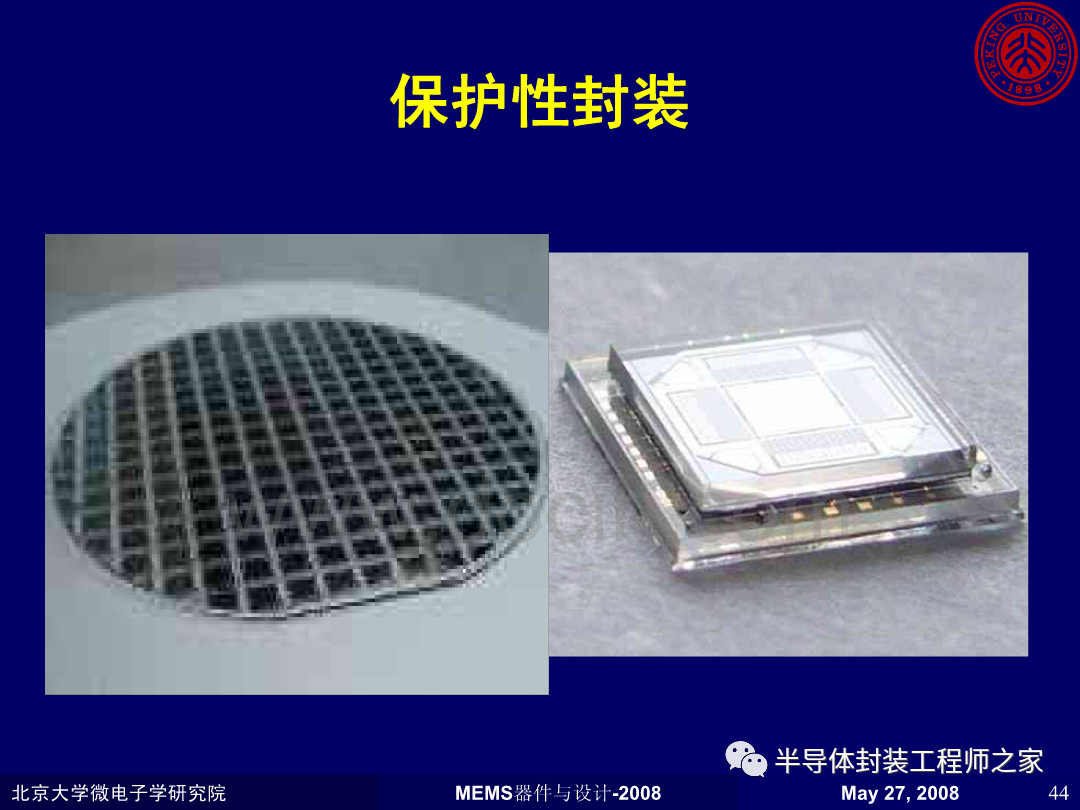




-
18 2022-02等离子清洗工艺在芯片键合前的应用
1 等离子清洗的原理
等离子清洗可分为化学清洗、物理清洗及两种混合清洗(如图1所示)。针对不同行业的清洗产品可选择相对应的工艺气体进行等离子表面处理。
1.1 化学等离子清洗
清洗反应是以化学反应为主的等离子体清洗。
可用氧气等离子体经过化学的反应可以使非挥发性的有机物生成易挥发的H2O和CO2,化学式为:

也可用氢气等离子体可以通过化学的反应去除金属表面的氧化层,清洁金属的表面,化学式为:

1.2 物理等离子清洗
清洗反应是以物理反应为主的等离子体清洗。

氩气离子在等离子产生的自偏压环境下被加速从而带有动能,然后离子轰击清洗工件表面,用于去除氧化物和环氧树脂的溢出物。
1.3 混合式等离子清洗
清洗反应中物理反应与化学反应均起关键作用。

2 等离子清洗工艺在芯片键合前的应用
2.1 等离子清洗工艺在IC封装行业中的应用
IC封装产品结构如图2所示,国内目前的IC封装工艺主要划分为前段、中段及后段工艺,只有封装质量好的产品才能成为终端产品,从而投入行业的实际应用,前段工艺步骤为:
1)贴片:使用保护膜及金属框架将硅片固定;
2)划片:将硅片切割成为单个芯片并对芯片进行检测,筛选检测合格的芯片;
3)装片:将引线框架相应位置点上银胶或者绝缘胶,从划片贴膜上将切割好的芯片取下,并将芯片粘接在引线框架的固定位置上;
4)键合:利用金线将芯片上引线孔以及框架上的引脚连接,使芯片与外部电路导通连接;
5)塑封:塑封元器件的线路,保护元器件不受外力损坏,加强元器件的物理特性;
6)后固化:对塑封材料进行固化,使其具有足够的强度以满足整个封装过程。
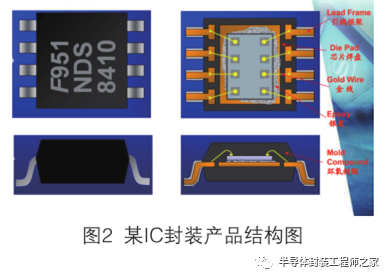
引线框架是芯片的载体,是一种利用键合金丝达到芯片内部电路的引出端与外引线的导通连接,形成电气回路的重要结构件,起到了与外部导线相接的桥梁作用。引线框架应用在很多的半导体集成块上,是半导体产业中重要的基础材料。IC封装行业工艺必须在引线框架上完成。在封装工艺中存在的污染物是制约其发展的重要因素。
等离子清洗工艺是唯一无任何环境污染的干法清洗方式。真空状态下的等离子作用能够基本去除材料表面的无机/有机污染,提高材料的表面活性,增加引线的键合能力,防止封装的分层。
等离子体清洗工艺在IC封装行业中的应用主要在以下几个方面:
1)点胶装片前
工件上如果存在污染物,在工件上点的银胶就生成圆球状,大大降低与芯片的粘结性,采用等离子清洗可以增加工件表面的亲水性,可以提高点胶的成功率,同时还能够节省银胶使用量,降低了生产成本。
2)引线键合前
封装芯片在引线框架工件上粘贴后,必须要经过高温固化。假如工件上面存在污染物,这些污染物会导致引线与芯片及工件之间焊接效果差或黏附性差,影响工件的键合强度。等离子体清洗工艺运用在引线键合前,会明显提高其表面活性,从而提高工件的键合强度及键合引线的拉力均匀性(如图3所示)。
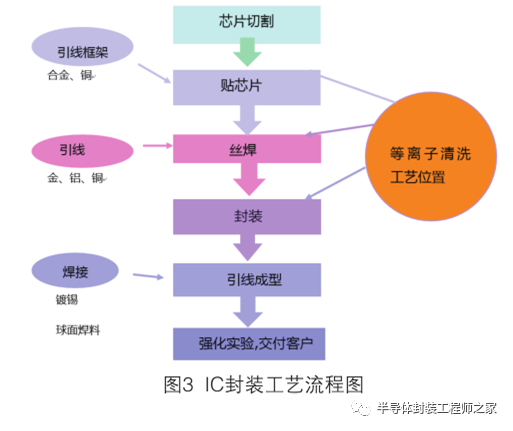
2.2 等离子体清洗工艺参数对清洗效果的影响
2.2.1 不同的工艺气体对清洗效果影响
1)氩气
物理等离子体清洗过程中,氩气产生的离子携带能量轰击工件表面,剥离掉表面无机污染物。在集成电路封装过程中,氩离子轰击焊盘的表面,轰击力去除工件表面上的纳米级污染物,产生的气态污染物由真空泵抽走。该清洗工艺可提高工件表面活性,提高封装中键合性能。氩离子的优势在于它是一个物理反应,清洗工件表面不会带来氧化物;缺点是工件材料可能产生过量腐蚀,但可通过调整清洗工艺参数得到解决。
2)氧气
氧离子在反应仓内与有机污染物反应,生成二氧化碳和水。清洗速度和更多的清洗选择性是化学等离子清洗的优点。缺点是在工件上可能形成氧化物,所以在引线键合应用中,氧离子不允许出现。
3)氢气
氢离子发生还原反应,去除工件表面氧化物。出于氢气的安全性考虑,推荐使用氢氩混合气体的等离子清洗工艺。
2.2.2 工艺时间
总体来说,最短的工艺时间是客户的基本要求,以便能够达到最大产能。但是工艺时间不是单一的因素,应该与射频功率、仓体压力和气体类型等参数相匹配,达到动态平衡。
2.2.3 仓体压力
反应仓内的压力是工艺气体流量、腔体泄露率和真空泵抽速的动态平衡。
物理等离子清洗工艺模式采用的仓体压力较小。物理等离子清洗工艺要求被激发的离子轰击工件表面。假如仓体压力过高,激发的离子在到达工件清洗表面之前就和其他离子产生多次碰撞,减低清洁效果。已激发的离子在碰撞之前所行进的距离称为离子的平均自由路程,与仓体压力成反比。物理等离子清洗工艺要求低压以便于平均自由路程最大化,使碰撞轰击达到最大。但假如仓体压力下降太多,就没有足够的活性离子在有效的时间内来清
洁工件。
化学等离子清洗工艺产生的等离子体与工件表面产生化学反应,所以离子数越多越能增加清洗的能力,导致需要使用较高的仓体压力。
2.2.4 射频功率
射频功率的大小会影响等离子体的清洗效果,从而影响封装的可靠性。加大等离子体射频功率是增加等离子的离子能量来加强清洗强度。离子能量是活性反应离子进行物理工作的能力。射频功率的设置主要与清洗时间达到动态平衡,增加射频功率可以适当降低处理时间,但会导致反应仓体内温度略有升高,所以有必要考虑清洗时间和射频功率这两个工艺参数。
2.2.5 等离子体清洗模式
主流的等离子清洗机有三种类型的电极载物板,用作设备的阳极、阴极以及悬浮极。根据工件的不同,调节电极载物板能够产生两种模式的等离子体,命名为直接等离子体模式和顺流等离子体模式。
直接等离子体模式是阳极和阴极相间放置,这种放置模式下所有产生的等离子体都会在阴阳两极之间往复运动,是轰击性比较强的模式。清洗工件可任意放置在阴阳两极。
顺流等离子体模式是阳极、阴极以及悬浮极的放置模式。在这种放置模式中,正离子能够到达悬浮极产生清洗作用。这种放置模式产生的等离子体相对较弱,可用来处理一些敏感元器件,如图4所示。
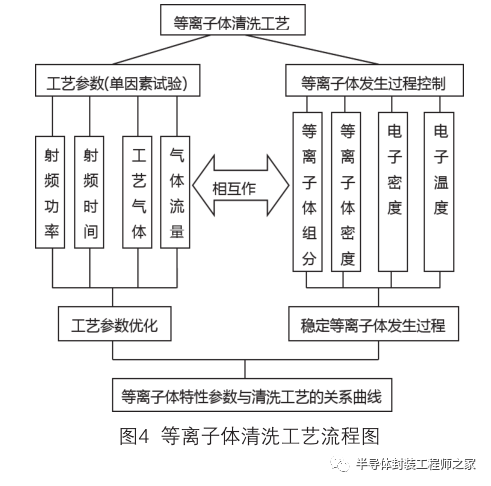
2.3 等离子清洗对芯片键合前清洗效果的影响
经过等离子清洗后,对工件芯片进行接触角测试,试验检测得出:未进行等离子体清洗的工件样品接触角大约在45°~58°;对已经进行过化学等离子体清洗的工件芯片的接触角大约在12°~19°;对工件芯片进行物理等离子体清洗过后其接触角在15°~24°。试验说明等离子体清洗对封装中芯片的表面处理是有一定效果的。图5为铜引线框架在等离子体清洗前后使用接触角检测仪进行测量的接触角对比,清洗前接触角在49°~60°,清洗后接触角在10°~20°,满足了工件表面处理需求。
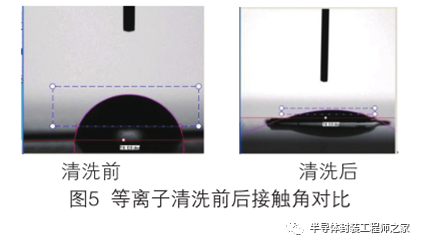
3 等离子清洗工艺试验
3.1 试验方法
在常温常压条件下,将120只试验的引线框架进行不同清洗工艺参数的等离子清洗,并通过接触角测试仪进行清洗后的接触角效果测试,找出最优化的清洗工艺参数。由于试验用的清洗材料有限,对于引线框架等材料进行裁剪,引线框架等清洗试验材料每个可以裁减成4份,所以共计进行480次的等离子清洗效果验证,找出最优化的清洗工艺参数。
3.2 试验过程
由于清洗试验次数较多,本次清洗工艺试验报告取五组工艺试验进行对比。被清洗元件为YX-001型引线框架,具体试验步骤为每次清洗取上中下三个点进行接触角测试,取平均值为最终接触角测试结果。
清洗配方见表1。

第一组配方在清洗完毕后进行接触角测试,接触角为19.78°,如图6所示。
第二组配方在清洗完毕后进行接触角测试,接触角为15.0°,如图7所示。

第三组配方在清洗完毕后进行接触角测试,接触角为13.5°,如图8所示。
第四组配方在清洗完毕后进行接触角测试,接触角为8.4°,如图9所示。
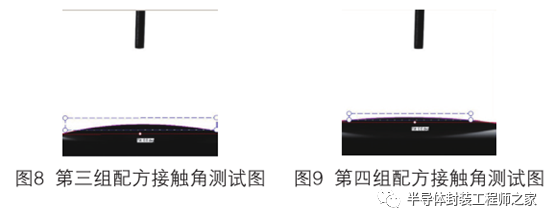
第五组配方在清洗完毕后进行接触角测试,接触角为21.5°,如图10所示。

3.2 试验结论
由以上试验得出的接触角测试结果可以看出第四组试验清洗效果最佳。
4 结束语
国内封装工艺水平极速发展,半导体制造技术极限受到挑战并持续发展,现在成为先进的前沿制造技术,这是关系国家安全和衡量国家制造水平的首要标准。随着国内封装芯片集成度的不断增加,芯片引脚数持续增多,引脚间距持续减小,芯片与基板上的有机和无机污染物必将制约着IC封装行业的发展,而现有的清洗均匀、一致性好、可操控性强及具有方向性选择处理的等离子清洗体清洗工艺应用于IC封装工艺中,势必将推动IC封装行业更加极速的发展。
-
14 2022-02哈佛大学锁志刚教授与科罗拉多大学Hayward教授 PNAS:基于离电子结的柔性温度传感器
最近,哈佛大学锁志刚教授与科罗拉多大学Ryan C. Hayward教授合作开发了一种基于离电子结的新型柔性温度传感器。该传感器的传感单元由离子导体、电子导体和介电层组成(图1)。离子积聚在离子导体与介电层的界面处,而电子则积聚在介电层与电子导体的界面处。通常,积聚的离子数与电子数并不相等,因而在离子导体中会形成具有一定厚度(分子尺度)的离子云。当温度发生变化时,离子云的厚度发生变化,继而产生随温度变化的电压。该温度传感器具有灵敏度高(~1 mV/K)、响应时间短(~10 ms)、自供电等优良特性,同时还具有多种传感构型,能够满足不同的应用需求。由于离子导体、电子导体和介电层皆可为软材料,该温度传感器具有柔性、可拉伸、透明等特点,可被广泛应用于不规则物体表面温度的精准测量。
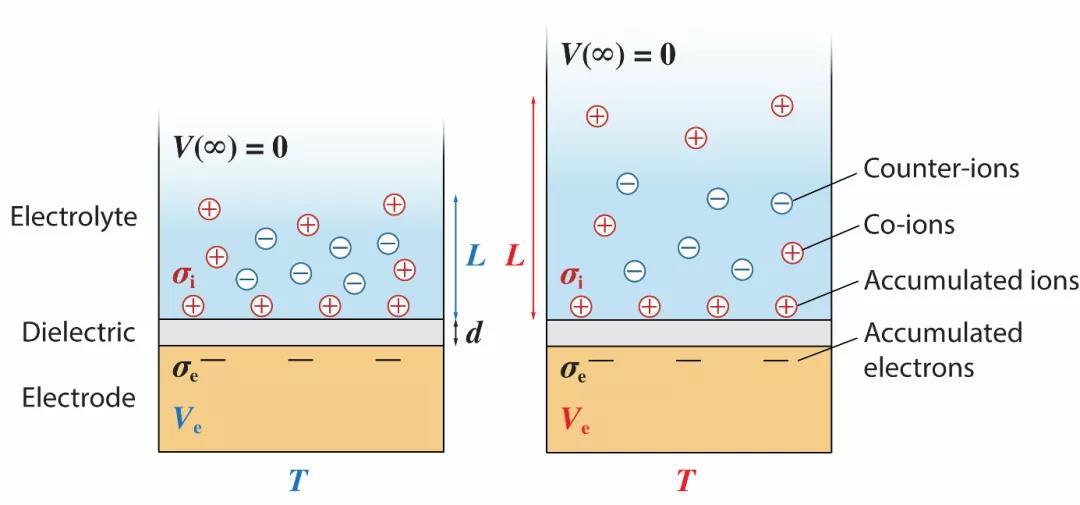
图1 工作原理
根据离子导体、电子导体和介电层的不同组合方式,温度传感器可设计成多种构型。当离子导体与电子导体不发生化学反应时,不需要引入介电层。首先,他们使用一种包含两个离电子结的传感构型,以含氯化钠水凝胶为离子导体,纳米银导电织物为传感端电子导体,金片为参考端电子导体,对温度传感的基本原理与特性进行了系统的研究(图2)。研究发现传感器灵敏度与离子浓度和传感端电子导体种类高度相关,其响应时间大约为10毫秒。
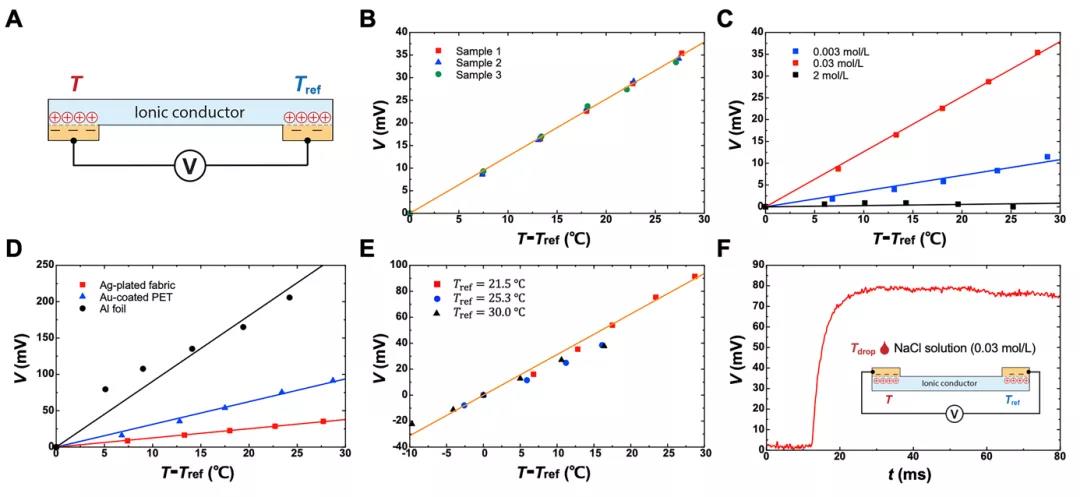
图2 基本特性
接下来,他们又为该温度传感器设计了三种构型,展示了传感器的可拉伸、透明、稳定以及灵敏度不随变形变化的重要特性(图3)。此外,为了展示该柔性温度传感器在可穿戴设备、软体机器人等领域的应用前景,他们将该传感器安装于自制软体机器手,在抓取物体的过程中实现了不规则表面温度的精准测量 (图4)。

图3 多种传感构型及相关特性

图4 可拉伸、透明温度传感器应用于不规则物体表面温度的精准测量
锁志刚教授团队与Ryan C. Hayward教授团队报道了一种新型基于离电子结的高灵敏、快响应柔性可拉伸温度传感器,深入系统地研究了其工作原理和基本特性,设计了四种传感构型,并展示了其广泛的应用前景。该研究为柔性传感器的设计提供了指导,也为下一代可穿戴设备、智能织物、软体机器人等的发展奠定了基础。
这项研究工作以Temperature sensing using junctions between mobile ions and mobile electrons为题发表于Proceedings of the National Academy of Sciences of the United States of America。论文第一作者为王叶成博士(哈佛大学博士、博士后),第二作者为贾坤副教授(西安交通大学),第三作者为张舒文助理教授(西安交通大学)。其他合作者包括Hyeong Jun Kim助理教授(韩国Sogang University)和白阳(西安交通大学研究生)。美国科学院院士、美国工程院院士、哈佛大学锁志刚教授和科罗拉多大学Ryan C. Hayward教授为论文通讯作者。
论文链接:
https://doi.org/10.1073/pnas.2117962119
-
10 2022-02SiP封装工艺6—Wire Bonding
Plasma Clean (电浆清洗Before WB)
在密闭真空中充入少量Ar、H2、O2中的一种或几种气体,利用RF power在平形板电极形成电场使电子来回震荡,电子激发并电离气体产生电浆,撞击基板和芯片表面,与污染物产生物理或化学反应,利用气体流通将污染物去除。电浆清洗使表面微结构产生官能基或达到一定的粗糙度,增加不同材料之间的结合力,增加焊点的可靠性以及基板与塑封材料之间的结合力,从而提高产品的可靠度、增加使用寿命。

Plasma Clean示意图电浆清洗主要分以下几种
1. Argon Plasma
纯物理作用、物理撞击可将表面高分子的键结打断,形成微结构粗糙面。
2. Oxygen Plasma
具有化学作用,可以氧化燃烧高分子聚合物,或者形成双键结构的官能子,可表面改性。
3. Hydrogen Plasma
具有还原性作用的气体,可以还原被氧化的金属表面层。
4. Mix Gas Plasma
组合上述气体种类,可达到特殊官能基的形成。Ar & H2混合气,借由物理撞击对表面的结构产生活化作用,并形成粗糙面增加结合力。Wire Bond工序前,采用此种清洗方式,可以增加焊点的结合力。O2& H2混合气,对金属面形成OH-基,Molding 工序前,采用此种清洗,可以增加与 Compound间的结合力。
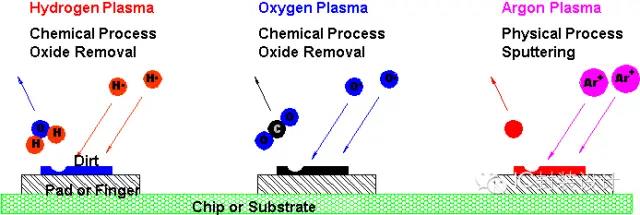
电浆清洗三种原理Plasma Clean (电浆清洗Before WB)
WB是封装工艺中最为关键的一步,主要目的是利用金线(Au)、铝线(Al)或铜线(Cu),把芯片上的Pad和基板上Finger通过焊接的方法连接起来。焊接方式有热压焊、超声键合和热超声焊等,这里主要介绍热超声焊。
热超声焊的主要材料为金线,成分为99.99%的高纯度金,线径一般为0.8mil,1.0mil,1.3mils,1.5mils和2.0mils等。利用超声振动提供的能量,使金丝在金属焊区表面迅速摩擦生热,产生塑性变形,破坏金属层界面的氧化层,两个纯净的金属界面紧密接触,在钢嘴压力作用下,达到原子间紧密键合,形成牢固的焊接。
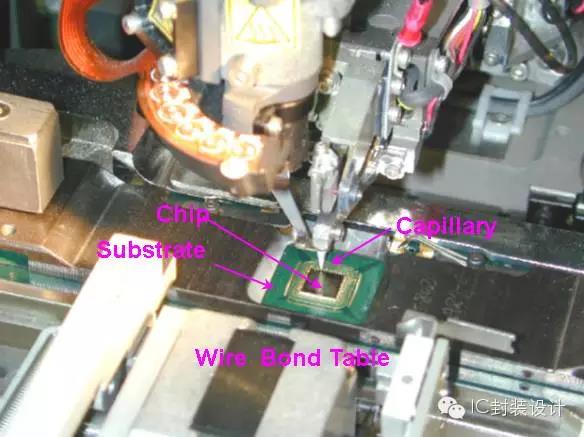
热超声焊球焊的主要过程如下图:
1) 打火杆在瓷嘴前打火,将金线烧熔成球;
2) 第一焊点:金球在钢嘴施加的一定压力和超声的作用下,与芯片pad连接,形成焊球(Bond Ball);
3) 第一焊点完成后,夹持金线的夹子松开,钢嘴牵引金线上升,并按程序设定的轨迹运动,从而形成一定的线型(Wire Loop)。
4) 第二焊点:钢嘴运动到基板Finger上方,在超声作用下,下压到在基板的Finger上,形成鱼尾(Wedge)形的连接;
5) 第二焊点完成后,钢嘴向上运动,拉出一定长度的金线(为下一步烧球做准备),夹子闭合,金线与Finger的连接被切断。
6) 回到第1),进入下一焊接循环。
WB四要素:压力(Force)、超声功率(USG Power)、时间(Time)、温度(Temperature)。

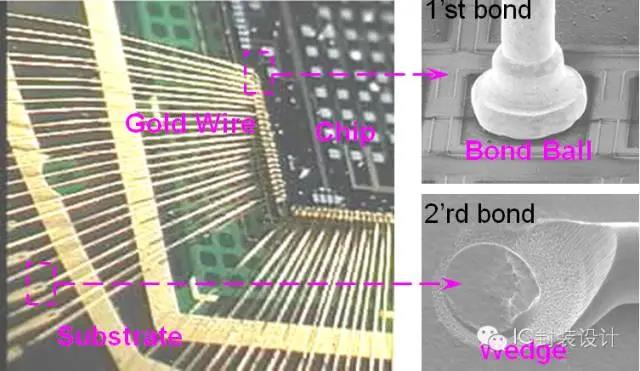
-
08 2022-02十种物理气相沉积(PVD)技术盘点
薄膜沉积是半导体制造工艺中的一个非常重要的技术,其是一连串涉及原子的吸附、吸附原子在表面扩散及在适当的位置下聚结,以渐渐形成薄膜并成长的过程。在一个新晶圆投资建设中,晶圆厂80%的投资用于购买设备。其中,薄膜沉积设备是晶圆制造的核心步骤之一,占据着约25%的比重。 薄膜沉积工艺主要分为物理气相沉积和化学气相沉积两类。物理气相沉积(Physical Vapour Deposition,PVD)技术指在真空条件下,采用物理方法,将材料源——固体或液体表面气化成气态原子、分子或部分电离成离子,并通过低压气体(或等离子体)过程,在基体表面沉积具有某种特殊功能的薄膜的技术。物理气相沉积原理可大致分为蒸发镀膜、溅射镀膜和离子镀,具体又包含有MBE等各种镀膜技术。发展到目前,物理气相沉积技术不仅可沉积金属膜、合金膜、还可以沉积化合物、陶瓷、半导体、聚合物膜等。 随着技术的发展,PVD技术也不断推陈出新,出现了很多针对某几种用途的专门技术,在此特为大家盘点介绍各种PVD技术。 真空蒸发镀膜技术 真空蒸发(Vacuum Evaporation) 镀膜是在真空条件下,用蒸发器加热蒸发物质,使之升华,蒸发粒子流直接射向基片,并在基片上沉积形成固态薄膜,或加热蒸发镀膜材料的真空镀膜方法。其物理过程为:采用几种能源方式转换成热能,加热镀料使之蒸发或升华,成为具有一定能量(0.1~0.3eV) 的气态粒子(原子、分子或原子团);离开镀料表面,具有相当运动速度的气态粒子以基本上无碰撞的直线飞行输运到基体表面;到达基体表面的气态粒子凝聚形核生长成固相薄膜;组成薄膜的原子重组排列或产生化学键合。 电子束蒸镀技术 电子束蒸镀(Electron Beam Evaporation)是物理气相沉积的一种。与传统蒸镀方式不同,电子束蒸镀利用电磁场的配合可以精准地实现利用高能电子轰击坩埚内靶材,使之融化进而沉积在基片上。电子束蒸镀常用来制备Al、CO、Ni、Fe的合金或氧化物膜,SiO2、ZrO2膜,抗腐蚀和耐高温氧化膜。 电子束蒸镀与利用电阻进行蒸镀最大的优势在于:可以为待蒸发的物质提供更高的热量,因此蒸镀的速率也更快;电子束定位准确,可以避免坩埚材料的蒸发和污染。但是由于蒸镀过程中需要持续水冷,对能量的利用率不高;而且由于高能电子可能带来的二次电子可能使残余的气体分子电离,也有可能带来污染。此外,大多数的化合物薄膜在被高能电子轰击时会发生分解,这影响了薄膜的成分和结构。 溅射镀膜技术 溅射镀膜技术是用离子轰击靶材表面,把靶材的原子被击出的现象称为溅射。溅射产生的原子沉积在基体表面成膜称为溅射镀膜。通常是利用气体放电产生气体电离,其正离子在电场作用下高速轰击阴极靶体,击出阴极靶体原子或分子,飞向被镀基体表面沉积成薄膜。 射频溅射技术 射频溅射是溅射镀膜技术的一种。用交流电源代替直流电源就构成了交流溅射系统,由于常用的交流电源的频率在射频段,如13.56MHz,所以称为射频溅镀。 在直流射频装置中,如果使用绝缘材料靶,轰击靶面的正离子会在靶面上累积,使其带正电,靶电位从而上升,使得电极间的电场逐渐变小,直至辉光放电熄灭和溅射停止。所以直流溅射装置不能用来溅射沉积绝缘介质薄膜。 磁控溅射技术 磁控溅射技术属于PVD(物理气相沉积)技术的一种,是制备薄膜材料的重要方法之一。它是利用带电荷的粒子在电场中加速后具有一定动能的特点,将离子引向被溅射的物质制成的靶电极(阴极),并将靶材原子溅射出来使其沿着一定的方向运动到衬底并在衬底上沉积成膜的方法。磁控溅射设备使得镀膜厚度及均匀性可控,且制备的薄膜致密性好、粘结力强及纯净度高。该技术已经成为制备各种功能薄膜的重要手段。 离子镀膜技术 离子镀是在真空蒸发镀和溅射镀膜的基础上发展起来的一种镀膜新技术,将各种气体放电方式引入到气相沉积领域,整个气相沉积过程都是在等离子体中进行,其中包括磁控溅射离子镀、反应离子镀、空心阴极放电离子镀(空心阴极蒸镀法)、多弧离子镀(阴极电弧离子镀)等。离子镀大大提高了膜层粒子能量,可以获得更优异性能的膜层,扩大了“薄膜”的应用领域。是一项发展迅速、受人青睐的新技术。 广义来讲,离子镀膜的特点是:镀膜时,工件(基片)带负偏压,工件始终受高能离子的轰击。形成膜层的膜基结合力好、膜层的绕镀性好、膜层组织可控参数多、膜层粒子总体能量高,容易进行反应沉积,可以在较低温度下获得化合物膜层。 多弧离子镀(MAIP) 多弧离子镀是采用电弧放电的方法,在固体的阴极靶材上直接蒸发金属,蒸发物是从阴极弧光辉点放出的阴极物质的离子,从而在基材表面沉积成为薄膜的方法。 多弧离子镀与一般的离子镀有着很大的区别。多弧离子镀采用的是弧光放电,而并不是传统离子镀的辉光放电进行沉积。简单的说,多弧离子镀的原理就是把阴极靶作为蒸发源,通过靶与阳极壳体之间的弧光放电,使靶材蒸发,从而在空间中形成等离子体,对基体进行沉积。 分子束外延(MBE) 分子束外延(MBE)是新发展起来的外延制膜方法,是一种在晶体基片上生长高质量的晶体薄膜的新技术。在超高真空条件下,由装有各种所需组分的炉子加热而产生的蒸气,经小孔准直后形成的分子束或原子束,直接喷射到适当温度的单晶基片上,同时控制分子束对衬底扫描,就可使分子或原子按晶体排列一层层地“长”在基片上形成薄膜。 该技术的优点是:使用的衬底温度低,膜层生长速率慢,束流强度易于精确控制,膜层组分和掺杂浓度可随源的变化而迅速调整。用这种技术已能制备薄到几十个原子层的单晶薄膜,以及交替生长不同组分、不同掺杂的薄膜而形成的超薄层量子显微结构材料。 分子束外延不仅可用来制备现有的大部分器件,而且也可以制备许多新器件,包括其它方法难以实现的,如借助原子尺度膜厚控制而制备的超晶格结构高电子迁移率晶体管和多量子阱型激光二极管等。我们在公车上看到的车站预告板,在体育场看到的超大显示屏,其发光元件就是由分子束外延制造的。 脉冲激光沉积(PLD) 脉冲激光沉积(Pulsed Laser Deposition,PLD),也被称为脉冲激光烧蚀(pulsed laser ablation,PLA),是一种利用激光对物体进行轰击,然后将轰击出来的物质沉淀在不同的衬底上,得到沉淀或者薄膜的一种手段。 由脉冲激光沉积技术的原理、特点可知,它是一种极具发展潜力的薄膜制备技术。随着辅助设备和工艺的进一步优化,将在半导体薄膜、超晶格、超导、生物涂层等功能薄膜的制备方面发挥重要的作用;并能加快薄膜生长机理的研究和提高薄膜的应用水平,加速材料科学和凝聚态物理学的研究进程。同时也为新型薄膜的制备提供了一种行之有效的方法。 激光分子束外延(L-MBE) 激光分子束外延技术(L-MBE)是近年来发展起来的一项新型薄膜制备技术,是将分子束外延技术与脉冲激光沉积技术的有机结合,在分子束外延条件下激光蒸发镀膜的技术。 L- MBE结合了PLD的高瞬时沉积速率(不需要考虑成分挥发时的热平衡问题等等)及MBE的实时检测功能,是一种改良的MBE方法。 近年来,薄膜技术和薄膜材料的发展突飞猛进,成果显著,在原有基础上,相继出现了离子束增强沉积技术、电火花沉积技术、电子束物理气相沉积技术和多层喷射沉积技术等。 目前,芯片制造过程中关键的PVD设备主要包括硬掩膜(Hard Mask )PVD设备、铜互联(CuBS)PVD 以及铝衬垫(Al PAD)PVD,主要使用溅射镀膜技术。 链接:https://www.instrument.com.cn/news/20210604/581996.shtml
来源:仪器信息网 -
20 2022-01面向窄节距倒装互连的预成型底部填充技术
近年来随着电子产品的小型化发展,窄节距倒装芯片互连已经成为研究热点。传统的倒装芯片组装后底部填充技术( 例如底部毛细填充) 在用于窄节距互连时易产生孔洞,导致可靠性降低,因此产业界开发了面向窄节距倒装芯片互连的预成型底部填充技术,主要包括非流动底部填充和圆片级底部填充。介绍了这类新型底部填充技术的具体工艺及材料需求,并提出了目前其在大规模量产以及未来更窄节距应用中存在的问题及挑战,总结了目前产业界在提高量产生产效率、提升电互连的可靠性以及开发纳米级高热导率填料等方面提出的解决方案,分析了该技术未来的发展方向。
1 引言
传统的底部填充技术是在完成倒装芯片互连之后进行的,因此也被称为组装后底部填充技术(Post-assembly Underfill)。应用最为广泛的是毛细底部填充(CUF)和模塑底部填充(MUF)。近年来随着系统集成度不断提高,倒装芯片上凸点的尺寸和节距也变得越来越小,凸点节距小于 100 μm,甚至不大于10 μm,传统的组装后底部填充技术由于是在凸点互连之后才进行底部填充的,常常会出现凸点间填充不完全到位、产生孔洞等缺陷,使封装互连的可靠性降低。
为了适应倒装芯片窄节距互连的填充需求,产业界提 出了 一种 新型 的预 成型 底部 填充 技术(PreassemblyUnderfill)。这种方法既能简化工艺,又能对窄节距互连(小于 100 μm)进行良好的底部填充。此外,研究机构还提出了一些方法对预成型底部填料的性能进行改进,从而实现低热膨胀系数(约 20×10 -6 /℃)、低粘度(小于 20 Pa·s)以及高热导率[大于1 W·(m·K) -1 ]等优良性能,进一步提高了预成型底部填充的可靠性。
本文将聚焦于窄节距倒装芯片互连中的预成型底部填充技术,介绍该技术的工艺流程以及材料特性,并针对其在实际生产中遇到的问题,总结目前已有的解决方案并预测这种技术未来的发展趋势。
2 预成型底部填充技术
传统的组装后底部填充技术主要适用于大节距凸点互连中,而对于节距小于 100 μm 的倒装芯片凸点互连,如仍采用这种技术,易在填充时产生大量孔洞,如图 1 所示。因此,对于窄节距倒装芯片互连,目前产业界多采用预成型底部填充技术。
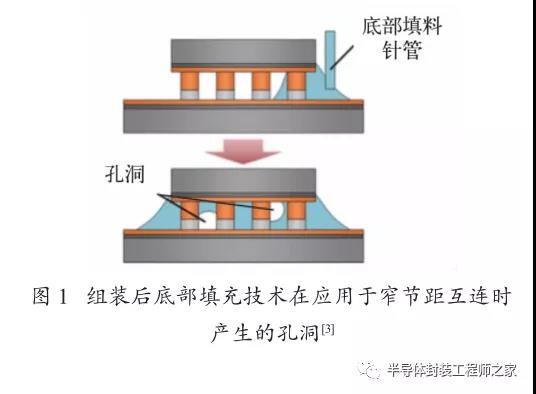
预成型倒装芯片底部填充技术是指底部填料在芯片互连之前就被施加在芯片或基板上,在后续的回流或热压键合过程中,芯片凸点互连与底部填充固化同时完成。该技术主要可以归纳为 2 种方法:非流动底部填充(NUF)和圆片级底部填充(WLUF)。
2.1 非流动底部填充
美国佐治亚理工学院于 1996 年首先提出了非流动底部填充技术并成功应用于无铅 C4 凸点的倒装芯片组装,具体工艺流程如图 2 所示。该技术省去了单独的助焊剂涂敷、底部填料的毛细流动注入和助焊剂清洗步骤,将焊料凸点回流和底部填充剂固化结合为一个步骤,从而既消除了底部填充时易产生的孔洞又提高了底部填充工艺的生产效率。

近年来,针对倒装芯片窄节距凸点的非流动底部填充技术也取得了发展。AMKOR 首先提出了利用非导电浆料(NCP)用作非流动底部填料,在实现凸点互连的同时完成 NCP 的固化,其工艺流程如图 3 所示。

早期针对大节距凸点(图 2)的非流动底部填充技术是通过回流来实现凸点互连与底部填料固化的,为了避免底部填料中的 SiO 2 颗粒镶嵌在互连界面影响接头的形成与电互连的可靠性,早期的底部填料中不含或只含很少的 SiO 2 填料。在基于 NCP 的非流动底部填充中(图 3),由于在键合过程中施加压力可以减少 SiO 2 颗粒在互连界面的镶嵌,因此 NCP 材料中含有 SiO 2 填料,同时有研究表明随着 NCP 中 SiO 2 填料质量百分比的增加,NCP 材料的热膨胀系数(CTE)会减小,而粘度和杨氏模量会增加,组装的可靠性也随SiO 2 填料的增加而有所提高。目前 NCP 非流动底部填充技术已经成功应用于 Samsung 手机处理器的封装中,如图 4 所示。
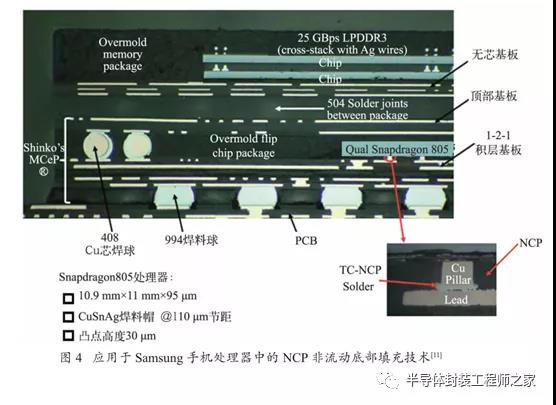
2.2 圆片级底部填充
为了进一步提高生产效率,产业界在非流动底部填充技术的基础上提出了圆片级底部填充技术。通过旋涂或层压的方式将底部填料施加在整个圆片上,然后将圆片划片切成单颗的芯片,最后通过回流或热压键合来实现芯片与芯片 / 基板之间的凸点互连与底部填料固化。
目前应用较为广泛的圆片级底部填料是非导电薄膜(NCF),NCF 是以膜的形式存在,可以通过夹在聚对苯二甲酸乙二醇酯(PET)之类的塑料薄膜中以卷材形式使用。这种特性有利于 NCF 在圆片级底部填充工艺中的应用,其工艺流程如图 5 所示 ,首先在圆片正面真空层压 NCF,然后在圆片背面贴划片膜,通过划片将圆片切成单颗芯片,最后倒装芯片经过热压键合实现互连与固化成型。这种基于 NCF 的圆片级底部填充技术多应用于节距为 40~80μm 的微凸点互连中。
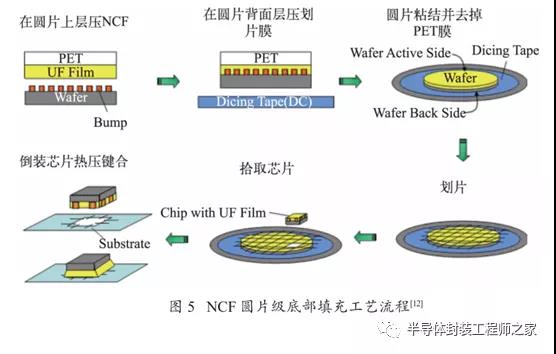
圆片级底部填充工艺成功的关键是要保证在划片之前,圆片上的底部填料处于半固化状态(B-Stage,或称 B- 阶),具有足够的机械强度和稳定性以满足后续划片、储存等的需求,图 6 为划片后的芯片边缘照片,没有发现底部填料的变形。同时处于 B- 阶的底部填料也具有“可回流性”,即具有熔化和流动的能力,从而在后续互连过程中焊料帽能够浸润焊盘并形成焊点。因此,对于成功的圆片级底部填充而言,保证底部填料处于 B- 阶以及控制后续的热压固化工艺是至关重要的。
同为预成型底部填充,NCF 的生产效率要比 NCP高很多,因为 NCF 可以在整个圆片上进行层压;同时NCF 工艺也较 NCP 更好控制,如热压过程中 NCP 的溢出较难控制,限制了其在三维封装方面的应用。但NCF 的缺点是流动性较 NCP 差,导致互连界面残留的底部填料较多,降低了接头的电互连可靠性;同时它不能灵活应对具有不同凸点高度的芯片,只能考虑配以不同厚度的膜。目前,Sanyo、Hitachi、Tohoku、DOW、Hynix、KAIST/Samsung 、Amkor/Qualcomm 和 Toray 等都对基于 NCF 的圆片级底部填充技术进行了研究,并应用于 2.5D/3D 集成中。图 7 为 Samsung 在其动态随机存储器中应用NCF 底部填充技术的实例,它实现了基于硅通孔(TSV)的 4 层存储芯片的互连与底部填充。

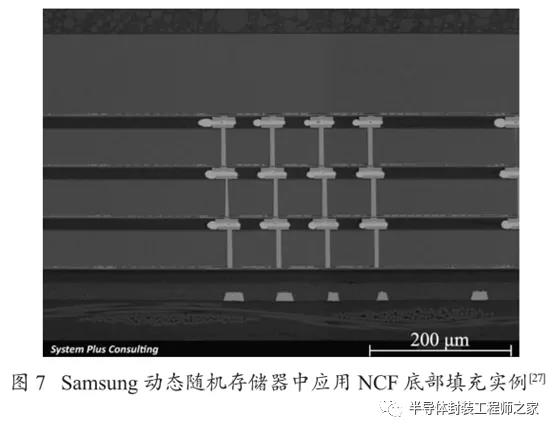
NCP 和 NCF 材料主要由基体胶、稀释剂、增韧剂和其他添加剂组成。基体胶主要有环氧树脂、酚醛树脂、聚酰亚胺及热塑性塑料等;稀释剂通常主要包括醇类、酯类稀释剂等;增韧剂包括低分子液体改性剂等非反应性增韧剂。NCP 材料的主要供应商有Henkel、Namics、Nagase、Hitachi、Panasonic 等,NCF 的供应商有 Henkel、Hitachi、Toray、Nitto Denko、Namics、Sumitomo 等。
3 预成型底部填充技术的最新进展
目前,利用 NCP/NCF 作为底部填料的预成型底部填充技术在窄节距倒装互连的三维堆叠存储芯片以及图像传感器芯片等方面都得到了较为广泛的研究与应用,但是在面向大规模量产和未来进一步的窄节距倒装互连时还存在一定的技术挑战,未来还需要在提高量产生产效率、提升电互连的可靠性以及开发纳米级高热导率填料等方向继续发展。
3.1 提高量产生产效率
预成型底部填充技术多用于节距小于 100 μm 的凸点互连,与传统的 C4 凸点大批量回流之后进行底部填充相比,一般一次热压过程只能完成一个芯片的键合与底部填充,因此整体的生产效率较低。
为了提高生产效率,TORAY提出了将热压键合过程分为 2 个过程进行:第一步是预键合,主要实现芯片的拾取和放置;第二步是主键合,通过一次热压过程完成多个芯片在基板上的键合。这种将预键合和主键合分步(PMD)进行的方法能够较好地提高生产效率。PMD 工艺流程如图 8(a)所示。它由 A 和 B 的 2 个并行工序组成,通过分步预键合 A 和主键合 B 的方法,压头的温度在整个过程中始终保持恒定,如图 8(b)所示,省去了压头升温和降温的时间,从而提高了生产效率。此外,预先施加的 NCF 也能够防止在从过程 A 到过程 B 的基板传输过程中芯片的移动。图 8(d)展示了键合后的互连界面截面图。
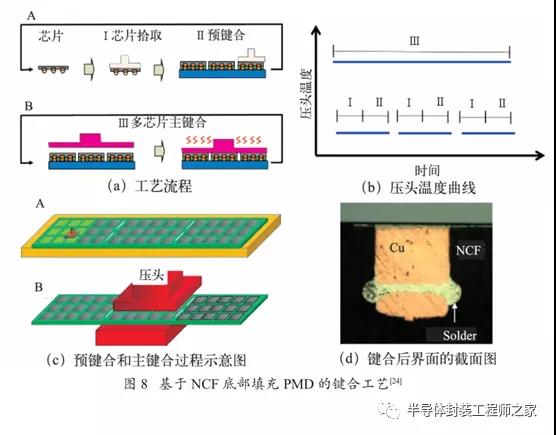
TORAY 这种分步键合的方法也可以用在芯片堆叠中以提高生产效率,如图 9 所示。图 10 为用这种方法键合后的三维芯片堆叠截面示意图,可以看到能够实现良好的三维堆叠互连。
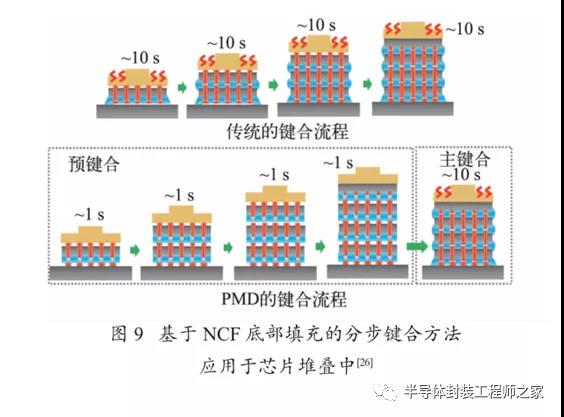
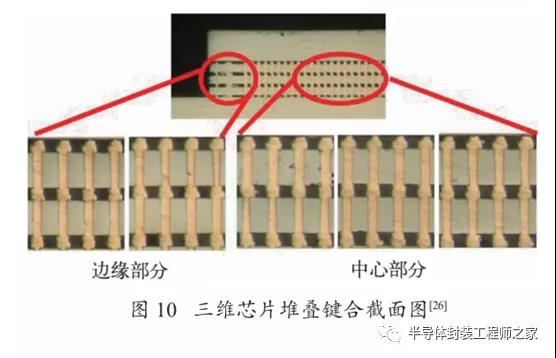
3.2 提高电互连可靠性
预成型底部填充技术在实际应用中的另一个主要问题是凸点处的电互连可靠性。由于底部填料在凸点互连之前就已经铺展在芯片载体上了,因此在凸点互连过程中,底部填料中的 SiO 2 填料很容易残留在凸点之间,如图 11 所示,从而降低互连的导电性能和载流能力,影响在高温 / 高湿或热循环下的可靠性。
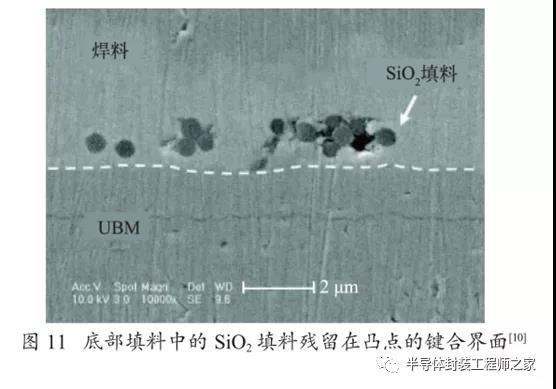
针对以上问题,很多公司及研究机构都提出了相应的解决方案,主要包括双层工艺、两步工艺、混合键合以及自组装技术等。
佐治亚理工学院、HITACHI等提出了使用两层非流动底部填料的方法。双层底部填充方法工艺流程如图 12 所示:首先在基板上施加一层底部填料,这种材料具有相对较高的粘度且不含 SiO 2 填料,然后在其上面再滴涂一层含有 SiO 2 的底部填料,最后将芯片放置在基板上进行键合,实现凸点互连与底部填料的固化。已有文献报道用含 65%(质量分数)的 SiO 2 填料的顶层底部填料可以实现 100%的互连良率。使用这种双层工艺虽然可以避免 SiO 2 颗粒的嵌入,但是在实际工艺过程中,需要对各工艺参数以及材料参数进行精确的控制,如底层材料的厚度和粘度对焊料凸点的润湿性起至关重要的作用,键合过程中的压力以及温度直接影响了 2 种材料的融合固化以及焊料凸点的互连等,因此实际生产中工艺窗口很窄。此外,由于该工艺中使用了 2 种底部填料,大大增加了工艺步骤和工艺成本。
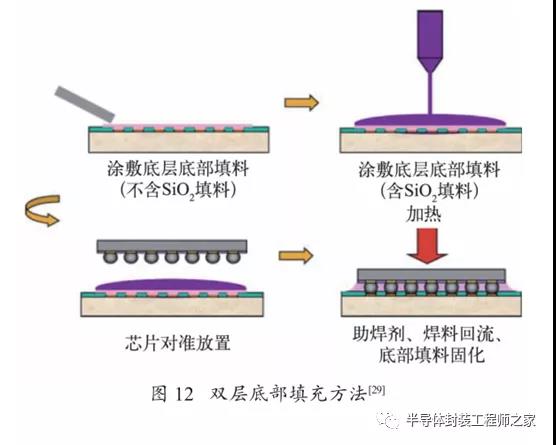
TORAY、IME等还提出了 2 步工艺的方法解决互连可靠性问题。即在圆片上施加 NCF 之后,通过化学机械抛光(CMP)、快速切割等方法,对凸点和底部填料的表面进行处理,一方面实现表面的平坦化,另一方面也可以去除凸点表面的底部填料,从而解决 SiO 2 填料的嵌入问题。利用快速切割的方式去除凸点上的底部填料工艺流程如图 13 所示。图 14 展示了表面处理后的效果,可以看到 CMP 之后凸点能够完全暴露出来。该方法的缺点是增加了工艺成本和工艺难度。在化学机械抛光中,需要选择合适的抛光液,从而同时实现 Cu/Sn 凸点与底部填料的平坦化。研究表明,对于嵌入底部填料中 Sn 凸点的化学机械抛光,其对抛光液的酸碱性有很强的依赖性,选择酸性-中性的抛光液能够实现更加平坦的表面。此外,利用快速切割的方法,容易在凸点及底部填料表面产生比较大的划痕。为了简化工艺、降低成本,早稻田大学提出了一种更为简单的结合等离子刻蚀的热压平整化工艺,如图 15 所示,也可以达到预期的效果。
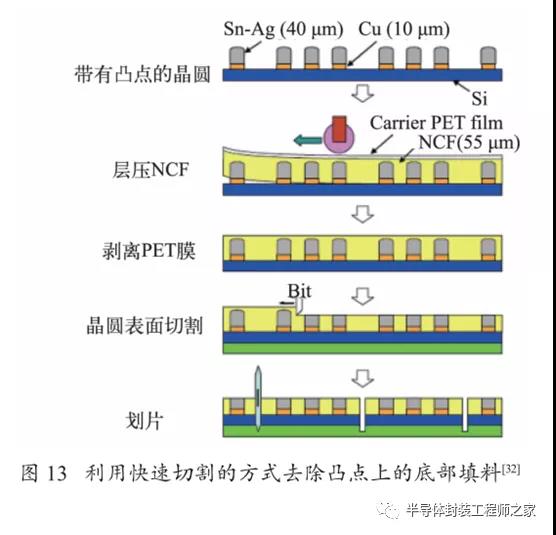
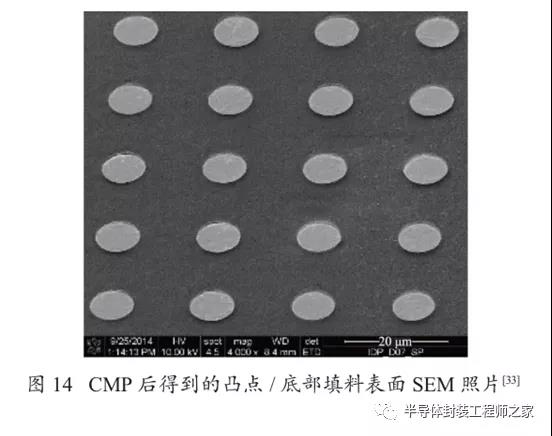
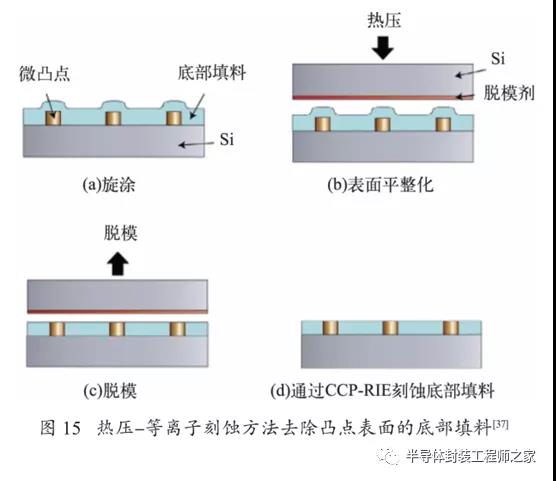
为了去除凸点表面的底部填料,提出了采用光敏光刻胶作为底部填料的方法。在完成圆片上的凸点制作之后,先旋涂一层光敏光刻胶作为底部填料,然后利用光刻技术对光刻胶进行图形化处理,去除凸点上的光刻胶,工艺流程如图 16 所示。由于凸点键合与光刻胶固化同时实现,该方法被称为混合键合。常用的光敏光刻胶有 BCB、PI、SU-8 等。目前有许多研究机构都对混合键合技术进行了研究。大连理工大学利用 Cu-SnAg 固液扩散键合技术来实现凸点互连,并采用 B- 阶干膜作为光敏光刻胶来实现底部填充,其键合工艺参数(温度 / 时间 / 压力) 为 240 ℃/10 min/10 kN,最终通过控制凸点厚度与有机物厚度同时实现了凸点互连以及光刻胶的固化。台湾交通大学也对混合键合进行了研究,在利用 Cu-Sn 固液扩散键合技术实现凸点互连的基础上,对比优化了使用不同光敏光刻胶(PI、SU-8 以及 BCB)对应的最佳键合工艺参数。清华大学采用了独特的非对称混合键合结构,即只在顶部圆片上进行光刻胶的旋涂、光刻等,而不对底部圆片进行任何工艺操作,从而保护了底部圆片上的器件结构,使其适用于 MEMS 圆片键合中。但由于光刻胶中一般不含 SiO 2 颗粒,其 CTE 值较常规底部填料高,因此使用混合键合方法对封装体整体可靠性的影响还需深入研究。
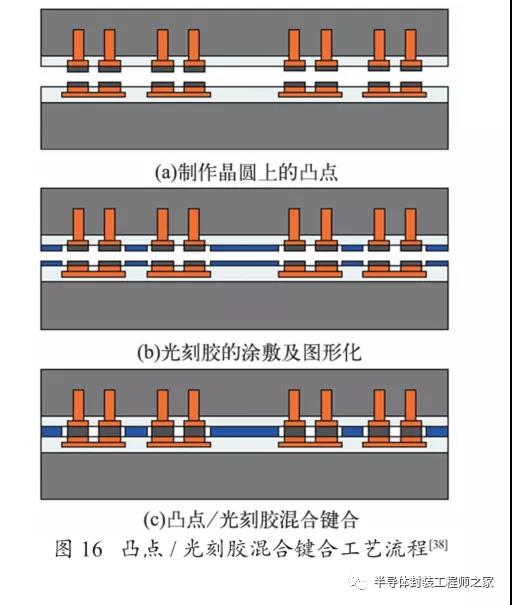
佐治亚理工学院 WONG 等还提出了一种新的自组装技术来解决 SiO 2 颗粒的嵌入问题,通过对焊盘及钝化层的表面预处理,使铜焊盘表面疏水而钝化层Si 3 N 4 表面亲水,从而实现底部填料的自组装,如图 17所示。研究结果表明,表面处理后的焊盘和钝化层表面的水接触角差值可以达到 119.9° (或底部填料接触角差值可以达到 91.6°),从而实现了自组装,解决了凸点互连中底部填料嵌入的问题。图 17 通过扫描电镜及能谱测试也展示了表面处理后铜焊盘上几乎没有SiO 2 颗粒,成功地实现了底部填料的自组装。文中还提出该自组装技术能够与市场上的商业底部填充剂相容。
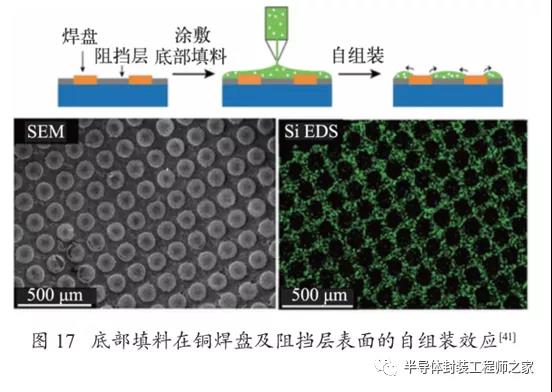
3.3 开发纳米级高热导率填料
预成型底部填充技术主要应用于倒装芯片窄节距互连中,芯片与基板之间的高度也比较小,传统底部填料中的微米级 SiO 2 颗粒难以满足节距及高度不断缩小的需要,很容易出现孔洞,因此利用纳米级SiO 2 作为填料成为了新的发展趋势,图 18 所示为制得的纳米 SiO 2 颗粒。市场上也开始出现了一些较为成熟的填充纳米 SiO 2 的底部填料。
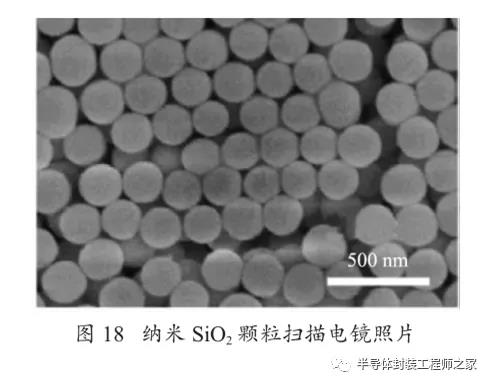
利用纳米 SiO 2 颗粒作为填料还存在一些问题:纳米 SiO 2 具有较大的比表面积和表面自由能,易于产生团聚,导致分散性较差;同时,填充纳米 SiO 2 后底部填料的粘度急剧增加,流动性变差;此外,严重的团聚会使填料与基体之间的界面结合变弱,降低底部填料整体的热机械性能。
研究结果表明,通过溶胶-凝胶法、化学沉淀法等制备得到的 SiO 2 纳米颗粒表面存在大量的硅烷醇,会导致底部填料的粘度增加,热机械性和可靠性也会下降。因此,为制备得到高性能的底部填料,去除 SiO 2 填料表面的-OH 基是非常必要的。表面改性是一种有效的方法,可消除-OH 的负面影响。最广泛使用的表面改性剂是硅烷偶联剂。由于其独特的结构,其一端可以与 SiO 2 填料发生物理或化学键合,另一端与聚合物基体实现优异的相容性,可以显著改善 SiO 2 在聚合物基体中的分散性和界面相容性。按照硅烷偶联剂的添加方法可以分为物理添加和化学改性。物理添加是直接将填料和偶联剂混合到环氧基质中,而化学改性是将改性后的 SiO 2 添加到环氧基质中。相比之下,化学表面改性可以在粘度和热机械性能方面实现更好的改善。图 19 所示为利用化学改性方法对纳米级SiO 2 颗粒进行表面处理后的效果,通过这种方法得到了分散均匀、与聚合物基体界面相容的纳米 SiO 2 填料,该复合材料的各项性能(包括粘度、CTE 等)都满足对底部填料的需求。
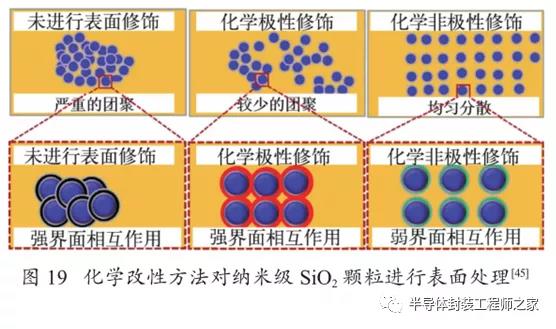
此外,随着对底部填料导热性能的需求进一步增加,需要开发新的材料来提高材料的热导率。目前的研究方向为用其他热导率较高的材料替换 SiO 2 颗粒作为新的填料,从而提高底部填料整体的热导率。有研究将具有高导热性的陶瓷填料如氮化硼、氮化铝、氧化铝和碳化硅等掺入环氧树脂,但是因为要实现高导热性能,往往需要填充大量的陶瓷填料,而这可能会导致底部填料的热机械性能变差,粘度变高。也有研究利用银纳米线(AgNWs)作为填料,但银的导电性能太好,因此底部填料的绝缘性无法得到严格的保证。有研究者提出了 AgNWs@SiO 2 核壳结构来作为填料,如图 20 所示。最终得到的 AgNWs@SiO 2 复合环氧基底部填料既可以实现较高热导率 [大于 1 W·(m·K) -1 ],又能满足底部填料绝缘性、粘度小于 20 Pa·s 等其他方面的性能需求。
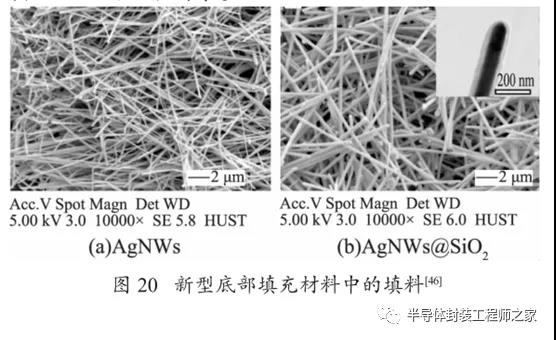
4 结论
随着倒装芯片底部凸点的节距越来越小,原来的组装后底部填充技术已不能适应 100 μm 以下的窄节距工艺,为了窄节距芯片互连的需要开发了预成型底部填充技术,该技术主要包括非流动底部填充和圆片级底部填充两大类。
以 NCP 为代表的非流动底部填充和以 NCF 为代表的圆片级底部填充均已成功应用于实际工业生产中。NCP 与 NCF 的材料组成基本相同,但 NCP 为液态,NCF 是以膜的形式存在,两者工艺不同。
针对 NCP/NCF 预成型底部填充技术生产效率较低、电互连可靠性以及材料性能等方面的问题,产业界提出了多种改进措施:针对提高生产效率,开发了分步键合的方法,该法也能用于芯片三维集成;为解决 SiO 2 颗粒嵌入互连界面的问题,提出了采用双层工艺、两步工艺、混合键合及自组装技术等解决方法,以去除凸点表面的底部填料从而得到更为可靠的电互连。底部填料性能的改进主要集中在填料的选择上:为适应窄节距互连,采用纳米级 SiO 2 填料并对易发生团聚的纳米 SiO 2 颗粒进行表面改性。此外,还可以通过将传统的 SiO 2 填料替换成热导率更高的陶瓷粉填料、氧化铝填料、纳米级 AgNWs、AgNWs@SiO 2 等材料来获得导热性能和可靠性更高的底部填料,以满足目前电子产品中更高的散热需求。今后窄节距倒装芯片的底部填充技术和高性能底部填充料的改进都仍将是微电子封装技术发展中的重要方向之一。
本文章来源于半导体封装工程师之家,仅限于分享交流,如侵权请联络管理人员进行删除







































